芯片资讯
- 发布日期:2025-08-28 16:42 点击次数:124
-
芯原股份
国内半导体 IP 龙头,Chiplet 业务进展显著:已助力客户设计基于 Chiplet 架构的高端应用处理器,采用 MCM 先进封装技术实现高性能 SoC 与多颗 IPM 内存合封;为高算力 AIGC 芯片开发 2.5D CoWos 封装方案;通过再融资布局 “A 股 IGC 及智慧出行领域 Chiplet 解决方案平台研发项目”,已形成 Chiplet 架构软硬件设计平台。 -
北极雄芯
推出全球首颗 Chiplet 异构集成自动驾驶芯片 “启明 935A”,采用 “启明 935 HUB Chiplet + 多颗大熊星座 AI Chiplet” 的灵活配置模式,结合定制化封装可快速集成不同性能等级的 SoC,适配多车型智能化需求;2025 年 6 月,其未来智驾 Chiplet 芯片总部落户无锡太湖湾科创城,依托当地集成电路集群开展业务。 -
其他国内设计企业
- 芯瑞微(上海)电子科技:专注 Chiplet 芯片设计,提供芯粒、芯片封装及仿真软件服务。
- 上海奎芯集成电路:聚焦算力扩展与高速互联问题,提供 Chiplet 集成电路整体解决方案。
- 奇异摩尔(上海)集成电路:国内 2.5D/3D IC 异构集成技术领先者,提供 Chiplet 产品及配套服务。
- 上海图元软件技术:深耕集成电路设计,将 Chiplet 技术融入核心业务流程。
- 比昂恒创(上海)科技:核心业务涵盖芯粒 Chiplet 开发与芯片设计服务。
- AMD:全球 Chiplet 量产先行者,处理器(如 EPYC 系列)采用 Chiplet 架构,通过异构集成提升性能与能效。
- 英特尔:在 Meteor Lake、Arrow Lake 等处理器中应用 Chiplet 设计,优化算力分配与功耗控制。
- 英伟达:AI 芯片(如 Grace Hopper 处理器)广泛采用 Chiplet 技术,结合高带宽存储提升算力密度。
- ARM:主导制定 Chiplet 互连标准 UCIe,推动全球 Chiplet 生态统一与协同发展。
-
华为四芯片(quad-chiplet)封装专利
专利或应用于下一代 AI 加速器升腾 910D,采用类似桥接设计(如台积电 CoWoS-L 或英特尔 EMIB+Foveros 3D),优化信号路径使芯片间互动延迟降低 40%;创新阶梯式散热方案,缓解多芯片叠加发热问题 30%,若落地昇腾 910D,单颗 GPU 封装效能有望超越 NVIDIA H100。 -
其他国内企业专利
- 宏茂微电子(2024 年 10 月):“一种 Chiplet 芯片扇出形封装结构”(授权公告号 CN 221885102 U),通过硅转接板侧面导电结构降本,开槽设计提升集成度。
- 晶通(2024 年 12 月):“一种改善 Chiplet 封装 Wafer 翘曲的封装结构”(公开号 CN119133114A),采用不锈钢 Carrier、UV 胶膜及刚性支架,提升封装平整度与稳定性。
-
多芯片混合集成技术
将先进制程计算单元(如 7nm/5nm 逻辑芯片)与成熟制程模块(如模拟电路、电源管理芯片)混合集成,在降低成本的同时保障性能;典型案例为 AMD EPYC 处理器,通过 3D 堆叠实现带宽与能效双提升,国内企业正积极探索该技术在工业、汽车电子领域的应用。 -
3D 堆叠技术
依托 TSV、混合键合等技术实现 Chiplet 垂直堆叠,显著提升互连密度:例如 HBM(高带宽存储器)通过 TSV 与逻辑芯片 3D 集成,带宽可达 819GB/s、延迟降低 80%;但需解决高深宽比(>1:10)TSV 填孔气泡残留、RDL 工艺良率控制等难题,依赖先进设备与工艺优化。 - 封测领域
- 通富微电:国内封测龙头,具备 Chiplet 量产能力,已为 AMD 大规模代工 Chiplet 产品。
- 长电科技:推出 XDFOI™ Chiplet 高密度多维异构集成工艺,实现高集成度异构封装体量产。
- EDA 与设计工具领域
- 芯和半导体:开发 Chiplet 先进封装 EDA 平台,提供从芯片到系统的全栈集成 EDA 解决方案。
- 比昂芯科技:专注 Chiplet 设计验证,核心产品 BTD-Chiplet 工具可大幅缩短设计周期(如 64 Dies AI 芯片设计从 2 个月 + 压缩至 2 小时 10 分钟),提供全流程软件、电路仿真及 AI 驱动 PDK 服务。
- 车载芯片领域
- 芯砺智能:全球首家采用 Chiplet 技术开发车载大算力芯片的企业,目标成为智能汽车平台芯片全球领导者。
- 台积电:提供成熟 Chiplet 封装服务(如 CoWoS 系列),为客户 Chiplet 设计落地提供制造支撑。
- AMD / 英特尔 / 英伟达:前文已提及,均为 Chiplet 技术应用核心推动者,覆盖处理器、AI 芯片等领域。
一、Chiplet 设计公司
(一)中国设计公司
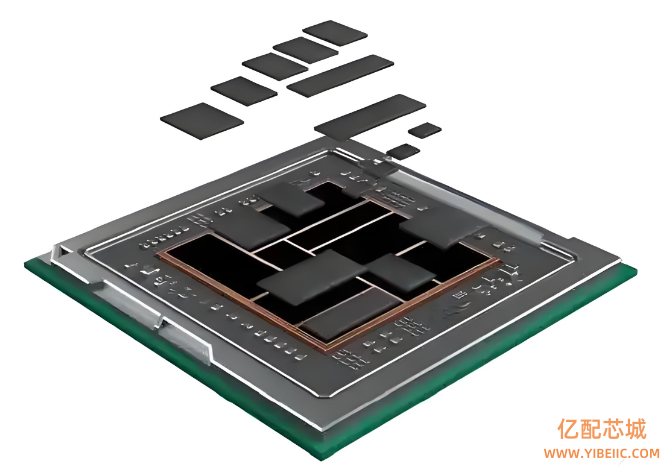
(二)国际设计公司
二、Chiplet 封装专利
(一)国内核心专利
(二)国际相关专利
华为 2025 年 6 月申请国际专利 “一种集成装置、通信芯片和通信设备”(PCT/CN2024/086375),聚焦四芯片封装设计,STM32,STM32系列通过桥接技术提升 AI 加速器性能,属全球 Chiplet 封装前沿探索。
三、Chiplet 封装技术与工艺
(一)主流封装技术分类
| 技术类型 | 核心方案 | 特点与优势 |
|---|---|---|
| 2D 封装 | 倒装芯片(Flip-Chip)、扇出型封装(Fan-Out) | 倒装芯片通过焊球 / 凸点提升 I/O 密度;扇出型封装借助 RDL(重布线层)增加 I/O 数量,适配多芯片集成需求 |
| 2.5D 封装 | 硅中介层(Silicon Interposer)、桥接技术(Bridge Technology) | 硅中介层通过 TSV(硅通孔)实现高密度互连;桥接技术嵌入硅桥,保障 Chiplet 间高速信号传输 |
| 3D 封装 | 垂直堆叠(3D IC)、混合键合(Hybrid Bonding) | 垂直堆叠通过 TSV 缩短信号路径;混合键合实现细间距互连(微米级),提升性能与可靠性 |
| 系统级封装(SiP) | 多芯片模组(MCM) | 将多颗 Chiplet 集成于同一基板,形成完整功能系统,兼顾集成度与灵活性 |
(二)关键集成工艺
四、Chiplet 相关企业(全产业链)
(一)国内企业
(二)国际企业
五、亿配芯城视角
亿配芯城作为深耕芯片领域的专业平台,始终密切追踪 Chiplet 技术演进与产业动态。依托与芯原股份、通富微电、比昂芯科技等全产业链企业的紧密合作,我们可为客户提供 Chiplet 相关芯片现货供应、定制化配单及解决方案支持,助力企业及时获取优质资源,精准把握 Chiplet 技术带来的产业机遇,共同推动中国 Chiplet 生态创新发展。
- 安世半导体遇 “双向围堵”:荷兰冻 147 亿资产,中国限在华器件出口2025-10-16
- 云天励飞发布新一代AI国产芯片首创14nm Chiplet大2024-02-11
- 国产芯片龙芯中科CPU:发展势头强劲,开启中国芯新时代2024-02-10







